Carsem is a global leader in MEMS & Sensors advanced packaging & test and is among the world’s leaders in microelectronics packaging.
Carsem has a dedicated MEMS & Sensors Business Unit (MSU) which drives focused investments in this area. MSU boasts of “advanced design, development & prototyping capabilities” to accelerate MEMS products towards mass manufacturing. By virtue of a strong automotive MEMS sensor portfolio, MSU’s emphasis on Quality continues to inspire customer’s confidence in its capabilities to launch new sensor packages in a variety of applications including Industrial, IoT, and Consumer segments.
Our dedicated and experienced MEMS Team can provide comprehensive turn-key solutions that begins with package co-design, thermal/stress simulations, engineered BOM selection for reliability, qualification support and in-house test development.


- Custom Molded Cavity Packages
- Lid packages with metal and plastics (LCP)
- Laminate and lead-frame base packages

- SOIC family
- QFN / DFN & Micro Leadframe Packages (MLP)
- LGA (LF, MIS) and Custom Packages
| APPLICATIONS |
| MEMS & SENSOR PACKAGING TYPE | OVERMOLD | MOLDED EXPOSED DIE | CAVITY / LID PACKAGES | |||||
| Inertial Accl, IMU | Magnetic | Current | Pressure | Humidity | Pressure | Humidity | Gas | |
| STANDARD JEDEC PACKAGES |   |
  |
  |
 |
  |
  |
 |
|
| CUSTOMIZED PACKAGES |  |
 |
 |
  |
||||
| SUBSTRATE BASED PACKAGES (MIS / BGA / LGA / CERAMIC) |   |
 |
 |
 |
 |
 |
||
| PRODUCT TYPE | PLATFORM | PRODUCT SIZE | THICKNESS (MOLD CAP) | SUBSTRATE / FRAME THICKNESS |
| LGA | OVERMOLD AND PREMOLD | 2MMX2MM UP TO 10MMX10MM | 0.52MM TO 1.2MM | 120UM TO 320UM |
| QFN | OVERMOLD STEP CUT AND INSERT MOLDING | 3MMX3MM UP TO 12MMX12MM | 0.6MM TO 1.0MM | 6MIL AND 8MIL |
| IC | OVERMOLD, PREMOLD AND INSERT MOLDING | SOICN / SOICW / CUSTOM | JEDEC | 8MIL AND 10MIL |
- A Fully Dedicated MEMS Staff
- History of Launching Difficult MEMS Sensors
- Thermal-Mechanical Simulation
- Electrical Simulations
- RF Simulation
- Mold Flow Simulation
- For Package & Board Level Reliability
- Cutting Edge MEMS Packaging Roadmap
- Advanced Electronics Materials Roadmap
- Advanced MEMS Wafer & Die Preparation
- Advanced MEMS Die Bond & Wirebonding
- Advanced Molding Technology for MEMS
- System in Package (SiP) Technology
- Flip Chip and CuPillar Technology
- Molded Interconnect Substrates (MIS)
- Dedicated MEMS Manufacturing Line
- IATF 16949, ISO-9001, ISO-14001, ANSI/ESD
- Investment in the latest Equipment
- State-of-the-Art Industry 4.0 Assembly
- Manufacturing Excellence System (MES)
- Complete traceability and data analytics

- Mold cap: 0.52mm – 1.2mm
- Substrate thickness: 120um – 320um
- Capability integration with SMT from 0201, 0402 and 0603

- Mold cap: 0.52mm – 1.2mm
- Lead frame thickness: 150um to 200um
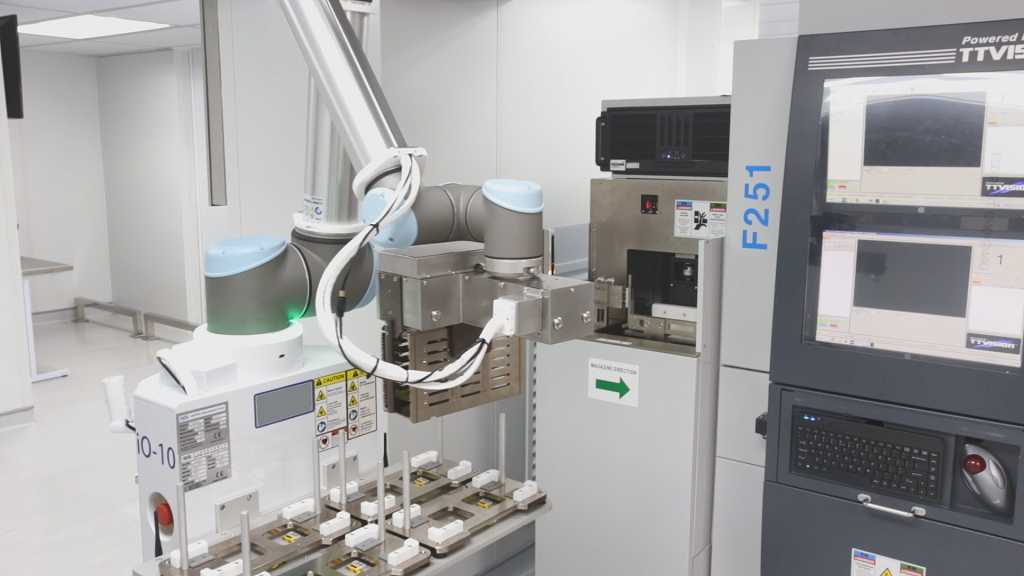
- The packages performance depends on customer requirements from MSL, MSL2 , MSL 3 to Automotive Grade 0 to 3.


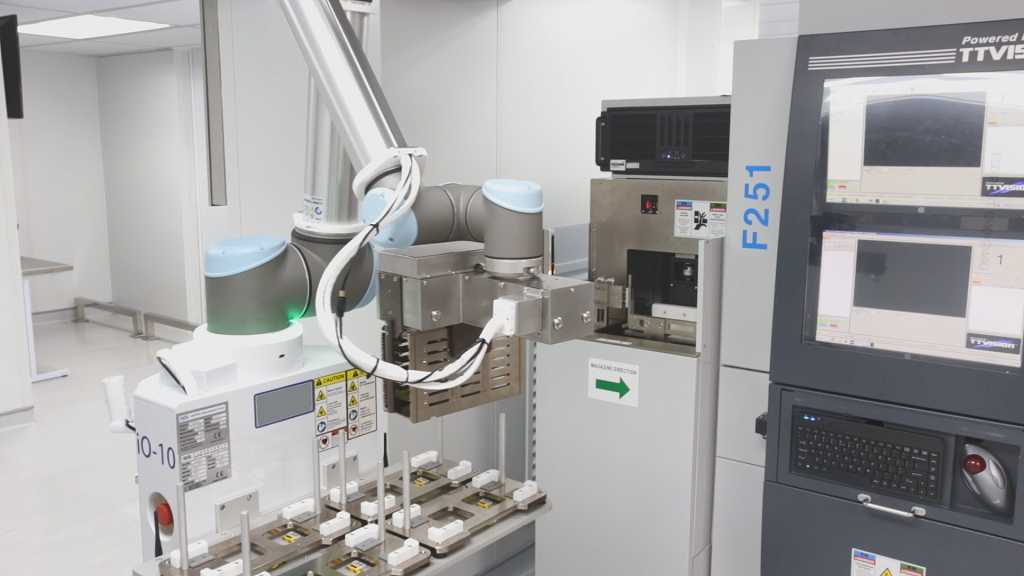
- Mold cap: 0.52mm – 1.2mm
- Substrate thickness: 120um – 320um
- Capability integration with SMT from 0201, 0402 and 0603
- Mold cap: 0.52mm – 1.2mm
- Lead frame thickness: 150um to 500um
- The packages performance depends on customer requirements from MSL 1, MSL 2 , MSL 3 to Automotive Grade 0 to 3.



