
Carsem’s SiP (System in Package) is the advanced technology of placing multiple ICs and passive components into a single package. Our services include design, modeling as well as final test including RF testing of Bluetooth and WLAN applications.
There is an almost endless list of potential SiP applications and some examples are :
- Bluetooth TM
- Wireless Devices
- 802.11 WLAN Applications
- Power Management Devices
- RF Power Amplifier
- GPS Modules
- Internet Mini-Systems
- Package construction : Leadframe and laminate based
- Package size up to 12×12 mm
- Terminal Pitches as fine as 0.4mm
- Package Thickness from 0.5 mm to 2.5 mm
- Flip chip, wire bond and stacked die capabilities
- Ability to mount passive components as small as 01005
SiP (System In Package) LGA is a package that consist of a combination of dies, passive components, or shielding in an IC package format. The connection of silicon die to package can be in the form of wire-bond or flip chip.
SiP LGA package is one of the most commonly industry standard packages. SiP is commonly used logic, memory, micro-controllers, automotive consumer and communications products. Such as RF Power Amplifier, GPS (Global Positioning System), and Power modules.
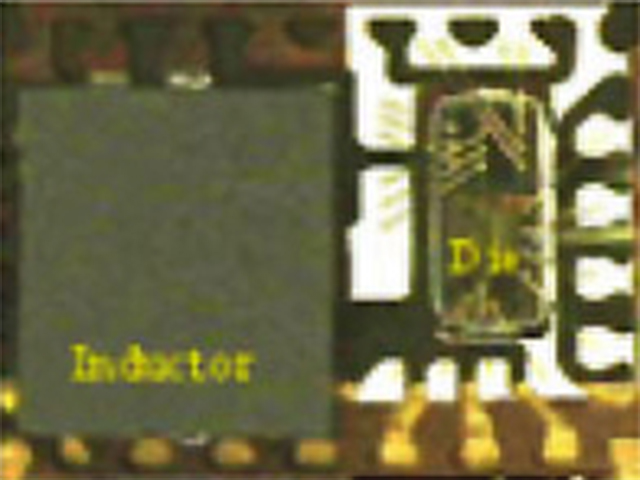
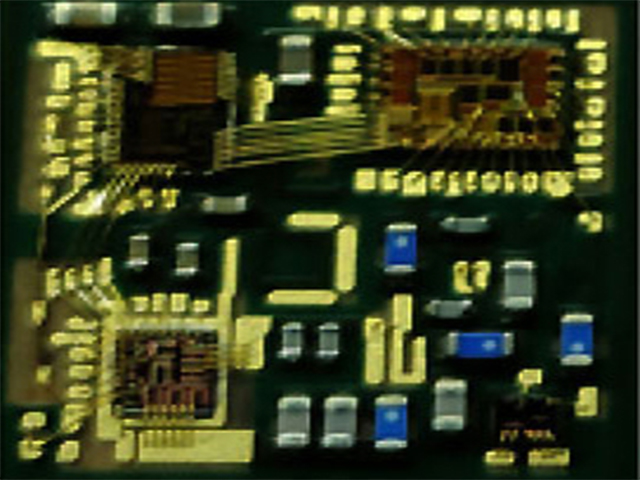
- GaN or GaAs wafer
- Multi die integrate in one package
- Critical WB parameter control
- Various components
Different frequency range for 4G/5G power amplifier production apply on smartphones.
- Multi die integrate in one package
- Various components
Widely used in automotive consumer and smartphones.